Cómo Soldar Matrices De Bolas ¿Qué Es Un Ball Grid Array?
A primera vista, soldar conjuntos de rejillas de bolas, BGAs, puede parecer difícil, ya que las bolas de soldadura que se sueldan en la PCB están intercaladas entre el propio cuerpo del BGA y la placa de circuito.
Sin embargo, se ha demostrado que el montaje de PCB con BGAs funciona, y funciona bien. Es posible que haya que modificar ligeramente el proceso de soldadura y otras áreas del montaje de la placa de circuito impreso, pero se ha comprobado que las ventajas de utilizar los BGA son bastante significativas, tanto en términos de fiabilidad como de rendimiento.
El Ball Grid Array, BGA, se introdujo como resultado del aumento significativo del número de pines en muchos chips. Los pines de los soportes, como el Quad Flat Pack, se volvieron muy delicados y fáciles de dañar.
Además, el enrutamiento de las placas de circuito impreso era difícil debido a la proximidad de muchos cables. El uso de toda la parte inferior del chip resolvió de una vez los problemas de densidad en los frágiles cables del chip.
Los componentes BGA proporcionan una solución mucho mejor para muchas placas, pero es necesario tener cuidado en el proceso de montaje de la placa de circuito impreso cuando se sueldan los componentes BGA para asegurarse de que se sueldan correctamente todas las juntas.
 Cómo Evitar Un Cortocircuito
Cómo Evitar Un Cortocircuito¿Qué es un Ball Grid Array?
El Ball Grid Array o BGA, es un encapsulado muy diferente a los que utilizan pines, como el paquete plano cuádruple. Las clavijas del paquete BGA están dispuestas en forma de rejilla, de ahí su nombre.
Además, en lugar de las tradicionales clavijas de alambre para las conexiones, se utilizan almohadillas con bolas de soldadura. En la placa de circuito impreso (PCB) en la que se instalan los componentes BGA hay un conjunto de almohadillas de cobre que proporcionan la conectividad necesaria.
Los paquetes BGA ofrecen muchas ventajas con respecto a sus rivales de paquete plano cuádruple y, por ello, se utilizan cada vez más para la fabricación de circuitos electrónicos:
- Mejora del diseño de las placas de circuito impreso gracias a la menor densidad de pistas: La densidad de pistas en muchos paquetes, como el paquete plano cuádruple, es muy alta debido a la gran proximidad de las patillas. Un BGA reparte los contactos por toda el área del encapsulado reduciendo en gran medida el problema.
- El paquete BGA es robusto: Los paquetes como el paquete plano cuádruple tienen clavijas muy finas, que se dañan fácilmente incluso con la manipulación más cuidadosa. Es casi imposible repararlos una vez que las clavijas se han doblado debido a su paso tan fino. Los BGA no sufren este problema, ya que las conexiones se realizan mediante almohadillas con bolas de soldadura BGA que son muy difíciles de dañar.
- Menor resistencia térmica: Los BGA ofrecen una menor resistencia térmica entre el propio chip de silicio que los dispositivos de paquete plano cuádruple. Esto permite que el calor generado por el circuito integrado dentro del paquete sea conducido fuera del dispositivo hacia la placa de circuito impreso de forma más rápida y eficaz.
- Mejora del rendimiento de alta velocidad: Como los conductores están en la parte inferior del soporte del chip. Esto significa que los conductores dentro del chip son más cortos. En consecuencia, los niveles de inductancia de los conductores no deseados son menores y, de este modo, los dispositivos Ball Grid Array pueden ofrecer un mayor nivel de rendimiento que sus homólogos QFP.
Proceso de soldadura BGA
Uno de los temores iniciales sobre el uso de los componentes BGA era su soldabilidad y si la soldadura de los componentes BGA podía ser tan fiable como la de los dispositivos que utilizan formas de conexión más tradicionales.
Dado que las almohadillas están debajo del dispositivo y no son visibles, es necesario garantizar que se utiliza el proceso correcto y que éste está totalmente optimizado. La inspección y la reelaboración también eran motivo de preocupación.
Afortunadamente, las técnicas de soldadura de BGA han demostrado ser muy fiables y, una vez que el proceso se ha configurado correctamente, la fiabilidad de la soldadura de BGA suele ser mayor que la de los paquetes planos cuádruples.
Mira También Cómo Funciona Un Resistor
Cómo Funciona Un ResistorEsto significa que cualquier montaje BGA tiende a ser más fiable. Por ello, su uso se ha generalizado tanto en el montaje de placas de circuito impreso de producción en serie como en el montaje de prototipos de placas de circuito impreso en los que se están desarrollando circuitos.
Para el proceso de soldadura de BGA se utilizan técnicas de reflujo. El motivo es que todo el conjunto debe alcanzar una temperatura que permita que la soldadura se funda bajo los propios componentes BGA. Esto sólo puede conseguirse mediante técnicas de reflujo.
En el caso de la soldadura BGA, las bolas de soldadura del paquete tienen una cantidad de soldadura muy controlada, y cuando se calienta en el proceso de soldadura, ésta se funde. La tensión superficial hace que la soldadura fundida mantenga el paquete en la alineación correcta con la placa de circuito, mientras la soldadura se enfría y solidifica.
La composición de la aleación de soldadura y la temperatura de soldadura se eligen cuidadosamente para que la soldadura no se funda completamente, sino que permanezca semilíquida, permitiendo que cada bola permanezca separada de sus vecinas.
Inspección de juntas de soldadura BGA
La inspección de BGA es un área del proceso de ensamblaje de placas de circuito impreso que ha suscitado un considerable interés desde que se introdujeron los BGA.
La inspección de los BGA no puede realizarse de forma normal mediante técnicas ópticas sencillas porque, obviamente, las juntas de soldadura están debajo de los componentes BGA y no son visibles.
Mira También Cómo Funciona un Giroscopio
Cómo Funciona un GiroscopioCuando se introdujo por primera vez, esta tecnología suscitó una gran inquietud y muchos fabricantes realizaron pruebas para asegurarse de que podían soldar los componentes BGA de forma satisfactoria.
El principal problema de la soldadura de componentes BGA es que hay que aplicar el calor suficiente para que todas las bolas de la rejilla se fundan lo suficiente para que cada unión de soldadura BGA se realice de forma satisfactoria.
Lee: Que Son Las Técnicas De Diseño EMC Y Cuantos Tipos De Diseño Hay.
Las juntas de soldadura no pueden probarse completamente comprobando el rendimiento eléctrico. Aunque esta forma de comprobar el proceso de soldadura BGA revelará la conductividad en ese momento, no ofrece una imagen completa del éxito del proceso de soldadura BGA.
Es posible que la unión no esté bien hecha y que con el tiempo falle. Para ello, el único medio de prueba satisfactorio es una forma de inspección de BGA que utiliza rayos X.
Esta forma de inspección de BGA es capaz de mirar a través del dispositivo a la unión soldada que hay debajo. Como resultado, la Inspección Automatizada de Rayos X, AXI, se convirtió en una tecnología de uso generalizado para la comprobación de los conjuntos de placas de circuito impreso que incluían BGAs.
Mira También Diferencias Entre Cable Trifásico Y Monofásico
Diferencias Entre Cable Trifásico Y MonofásicoAfortunadamente, se ha comprobado que una vez que el perfil térmico de la máquina de soldar está configurado correctamente, los componentes BGA se sueldan muy bien y se encuentran pocos problemas con el proceso de soldadura de BGA.
Repetición de la BGA
Como es de suponer, no es fácil reajustar los conjuntos BGA a menos que se disponga del equipo adecuado. Si se sospecha que un componente BGA está defectuoso, es posible retirar el dispositivo. Esto se consigue calentando localmente el componente BGA para fundir la soldadura que hay debajo.
En el proceso de reparación de BGA, el calentamiento suele realizarse en una estación de reparación especializada. Ésta consta de una plantilla equipada con un calentador de infrarrojos, un termopar para controlar la temperatura y un dispositivo de vacío para levantar el paquete.
Hay que tener mucho cuidado para garantizar que sólo se calienta y se retira el BGA. Los demás dispositivos cercanos deben verse afectados lo menos posible, ya que de lo contrario podrían resultar dañados.
La tecnología BGA en general y, en particular, el proceso de soldadura BGA han demostrado ser muy exitosos desde que se introdujeron por primera vez. En la actualidad, forman parte del proceso de montaje de placas de circuito impreso utilizado en la mayoría de las empresas para la producción en serie y el montaje de prototipos de placas de circuito impreso.
Mira También Qué Es La Pasta De Soldar Y Cómo Utilizarla
Qué Es La Pasta De Soldar Y Cómo UtilizarlaDeja una respuesta

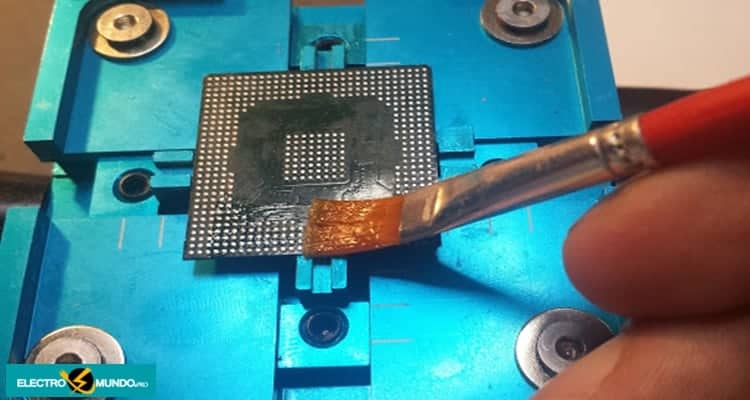
►TAMBIÉN DEBERÍAS LEER...